近年来,便携式发展和系统小型化的趋势,要求芯片上集成更多不同类型的元器件,如RF IC、各类无源元件、光机电器件、天线、连接器和传感器等。单一材料和标准工艺的SoC受到了限制,在其基础上,快速发展的系统级封装(SiP)在一个封装内不仅可以组装多个芯片,还可以将上述不同类型的器件和电路芯片叠在一起,构建成更为复杂的、完整的系统。
SiP技术的优越性包括:可提供更多新功能,多种工艺兼容性好,灵活性和适应性强,成本低,易于分块测试,以及开发周期较短等。SiP采用近十年来快速发展的倒装焊技术,与引线键合相比,倒装焊技术具有直流压降低、互连密度高、寄生电感小、热特性和电学性能好等优点,但费用较高。
SiP的另一大优点是可以集成各种无源元件。无源元件在集成电路中的用量日益增加,例如,在手机中无源元件和有源器件之比约为50:1。采用近年来发展的低温共烧多层陶瓷(LTCC)和低温共烧铁氧体(LTCF)技术,即在多层陶瓷内集成电阻、电容、电感、滤波器和谐振器等无源元件,就如同在硅片中集成有源器件一样。
系统级模块封装
硅是一种可作为几乎所有半导体器件和集成电路基板的材料。单晶硅具有平滑研磨面,在150μm跨度内,平整度为60μm。硅作为基板材料,引人注目的综合性能是热导率高、成本低、化学惰性和不透水性好、理想的机械性能、良好的一致性和可控性。硅基板的主要优点包括:和IC芯片的热膨胀匹配良好;较高的热导率,在85~135W/(K·m)之间;通过热氧化硅,表面形成二氧化硅,将隔离电容成批制作,并集成在硅基板中,从而使互连数量减少,改善了可靠性;电阻和有源器件也可在硅中单独制作;通过高掺杂(高导电性硅基板),硅基板可以起接地层的作用,免去金属化;硅易于用铝或其他金属进行金属化,在个别情况下,必须粘接媒介材料。但是,硅基板也有以下缺点:硅材料的机械强度低,加工时要倍加小心,以免开裂或损坏;它的抗弯强度比氧化铝低,在淀积厚的介质层和金属化层后产生较大的弯曲和翘曲。
近些年,硅封装基板已被用来提高系统级封装应用方面的互连密度。STATS ChipPAC公司适合于其无源元件和IC集成化的芯片级模块封装(CSMP)就是在SiP应用中采用硅作为基板材料的一个实例。
该公司使用薄膜技术在硅基板上制造集成化无源元件(IPD)。把一个或多个芯片粘贴到有IPD基板的倒装片上,接着进行封装,要么使用倒装焊,要么使用引线键合粘附,如图1所示。所得到的SiP为拥有球栅阵列(BGA)和平面栅格阵列(LGA)等形态。
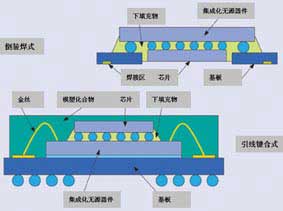
图1:采用倒装焊及引线键合技术构造的CSMP基板
该封装应用于要求高精度、尺寸小的无源元件,如无线电及射频无线电收发两用机、前端产品,以及用于移动式器件的放大器模块。
系统级封装的应用发展
SiP是一种具有高成本效益与灵活性的封装技术。将多个具有不同功能的芯片封装在同一个器件内,以形成一个完整的系统或子系统功能,如多芯片模块(MCM)、微电子机械系统(MEMS)和微光机电系统(MEOMS)等。即在一个普通的IC封装内,将各种半导体模块与其他无源和有源元件整合,这将为消费电子业带来大量的益处。在许多高性能以及受空间影响(space-sensitive)的应用上,在一个IC封装内的SiP技术正迅速的成为最佳选择。
SiP主要应用于换代周期较短的消费类产品,如手机等。以其进入市场快、更轻薄和更多的功能的竞争力,SiP目前已在工业界得到广泛地应用。其主要应用领域为射频/无线、移动通信、网络设备和计算机等。
