
1.技术概览:
第三代完全电介质绝缘的互补 SiGe BiCMOS 工艺 (BiCom3) 针对超高速高精度模拟集成电路而设计。上述器件的工作电压为 5V,可在广泛的温度范围内工作,其 fT 的范围为 15-20 GHz,fmax 的值则达 40-50 GHz 的范围,并最小化了集电极到基板的寄生现象。FT 的值反应出其性能比前一代互补技术要提高近三倍。
此器件建立在商用 SOI 晶圆之上。首先定义掺质浓度较大的 p 及 n 埋层。随后沉淀的是0.65um的本征外延层,再加上填入氧化物的深、浅沟槽,尽可能减小寄生现象并提高电路密度。在确定双沟道 (bipolar sinker)、CMOS 阱与栅层叠后,我们采用新颖的 dual-epi 工艺来形成 NPN 及 PNP SiGe 双基极区。多发射极的尺寸极小,仅为 0.4 x 0.8μm2,采用独特的界面处理工艺处理技术形成。CMOS 栅极、多晶硅高精度电阻及双基极多晶硅同时形成图案。我们在基极接触点上还采用 CMOS 源/漏注入。在多晶硅底板上采用 TiN 顶板,由此形成 MIM 电容,并选择氧化电介质实现低电介质吸收效果。最后,我们将可用激光修整的 NiCrAl 薄膜电阻器集成到 1.0 mm 间距的 TLM 后端,从而完成有关工艺。图 1 显示了最终 NPN 及 PNP 器件的截面视图。
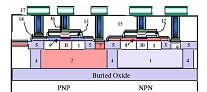


2.双极晶体管性能特点:
该技术的主要组件为双极管。对于使用互补设计的高性能模拟应用,使 NPN 与 PNP 的 fT 性能合理正确地匹配(因数在 2 以内)极为有用。除高 fT 之外,高速线性运算放大器以有其它信号调节电路也需要高晶体管增益,主要特点简而言之就是 βoVA 的积。增加 VA 通常以 fT 为代价,因为这需要提高基的掺杂级,因而导致移动性降低,并增加了发射极电容。添加 SiGe 可以增强基场 (field),从而抵消上述影响,这样在提高 VA 同时可得到更大的 fT。表 2 给出了双极晶体管在室温下的特性。
NPN 与 PNP 的 fT 及 fmax 曲线图分别在图 2 及图 3 中给出,这里的器件为 0.4 x 0.8 um2 器件,而图 4 和图 5 则给出了有关器件的 Gummel 图。 
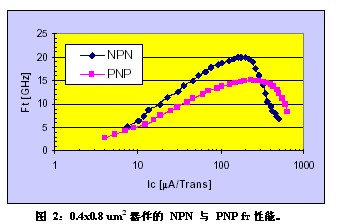
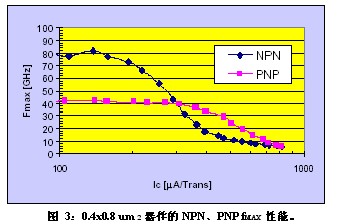
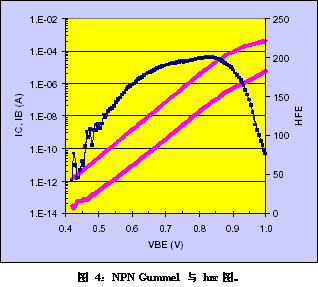
3.CMOS 与无源组件
除了双极组件外,5V CMOS 也集成到工艺流程中,以支持信噪比 (SNR) 性能要求较高的高速模数转换器 (ADC)。表 3 列出了 BiCom3 CMOS 晶体管特性。