
简介
由于高掺杂多晶硅具耐高温以及与传统制程兼容的优点,早期用以作为金属半导体场效应管栅电极的材料。但因其电阻值大于 400m?cm,在次微米组件上被电阻值低一个数量级以上的多晶硅-金属硅化物(polycide)取代。所谓多晶硅-金属硅化物是指在多晶硅上再沉积一层低电阻值的硅化物,而形成层叠结构(图1)。在VLSI制程上,硅化钨由于能耐高温又具低电阻值、低应力,被用来与多晶硅(Polysilicon)一起作为栅电极的导电材料。
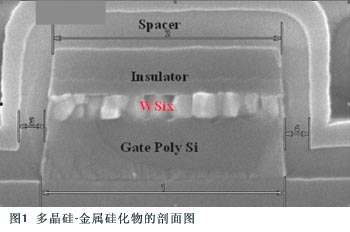
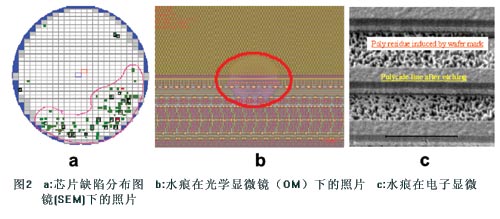
实验设备
实验所用扫描芯片(wafer)表面缺陷的设备是由KLA Tencor公司制造的SP1,为了能有效捕捉到水痕,扫描程序精度选用(>0.16um)。清洗设备是由S.E.S.公司制造的BW2000型酸槽,其干燥部分(model:RD2)使用常温氮气(PN2)和70℃IPA.
实验原理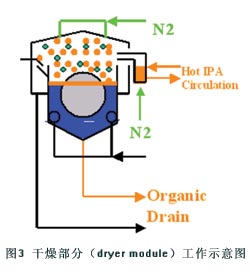
干燥的过程就是在一个充满氮气和IPA的混合气体的密闭室(chamber)中,利用表面张力变化差异将芯片与水(DIW)脱离的过程(详细动力学过程及整个工作过程限于篇幅,不作说明),见图3。
在此过程中,影响干燥效果的关键参数:N2/IPA混合气体流量(flow rate),芯片与水脱离的相对速度(实际操作时可通过排水和将芯片托起水面两种方式实现)。以上两个关键参数的合理匹配,是有效避免水痕的关键。
生产中出现水痕的干燥程序使用一段式的固定速度排水的模式使芯片脱水。本试验中采用将芯片托起水面,相对速度选用二段式的干燥模式:开始到芯片的2/3露出水面时速度为X1,芯片的下1/3的托起速度为X2,其中X2=1/2*X1。以此二段式相对速度为基本条件,调整N2/IPA混合气体流量f,通过实验找到最优化的气体流量范围。设计N2/IPA混合气体流量f分别有:a,b,c,d,e,其中a=20e,b=10e,c=4e,d=2e。
测试芯片的准备以及实验步骤
本实验采用N型硅表面的芯片(bare wafer)来模拟实际产品中的高掺杂多晶硅(磷掺杂,n型表面)。每次测试选用3片芯片(清洗前表面缺陷数<50颗),放置在位置1,25,50(酸槽一次可同时清洗50片芯片),分别在N2/IPA混合气体流量f为a,b,c,d,e,芯片托起水面的相对速度固定为X1/X2二段式的设定参数下使用稀释的HF(100:1)对其进行清洗。在清洗前后1小时内,使用SP1对芯片表面进行缺陷检查,通过比较实验前后芯片缺陷的分布图,就可找到最优化的气体流量范围。
试验结果及分析
右表列出了实验的结果,我们可以看到在二段式的相对速度下,随着N2/IPA流量的减小,表面微粒 (surface particle)和水痕都在随之减少。由于e接近设备所能控制流量的精度,所以流量d就是我们所要寻找的最优化条件。
(surface particle)和水痕都在随之减少。由于e接近设备所能控制流量的精度,所以流量d就是我们所要寻找的最优化条件。
这与之后我们在实际产品上所做实验看到的结果完全一致,证明二段式的相对速度与低流量d的N2/IPA完全能避免水痕产生,同时有效提高了清洗能力。
仔细分析图2产品的缺陷分布图,可以发现大部分水痕出现在芯片的下半部接近1/3以下面积,并且靠近边缘。当排水使芯片露出水面一半后,由于芯片与水面的交线开始收缩,在排水的速度还是较快时,这种收缩就会在高度斥水性的多晶硅表面就极易导致脱水不均,从而形成水痕。因此此次实验选用了二段式相对速度脱水法,在芯片与水面的交线开始快速收缩时,减慢相对速度来避免此种情况的发生,同时采用将芯片托起水面的脱水模式以提高相对速度的均匀性。在此芯片托起水面,相对速度选用二段式的干燥模式下,通过以上实验我们就找到了避免水痕产生的N2/IPA混合气体的最佳流量。
结论
Polycide制程中,在沉积WSIx前的去除自生氧化物的HF清洗,极易形成水痕而造成良率的重大损失。本例中根据高掺杂多晶硅表面经过HF清洗后高度斥水性的特点,采用将芯片托起水面,相对速度选用二段式的干燥模式,同时选择适当的N2/IPA流量,经过大量生产证明,能够成功地避免水痕的产生,从而大大地提高产品良率。